6月9日报道,台积电目前最大的封测厂:竹南先进封测六厂(AP6)已正式启用,成为台积电第一座实现3D Fabric封装技术,整合前段至后段制程以及测试服务的自动化先进封装测试厂。这一工厂的启用,也为目前吃紧的CoWos产能带来一场及时雨。
3D Fabric 3D封装技术包含CoWos、InFO、TSMC-SoIC等多种细分技术,其目的均是将多片硅晶芯片封装至基板上,实现多个小芯片之间的互联整合。目前台积电的CoWos技术已经应用于苹果M1 Ultra、M2 Ultra、AMD MI200/MI300、谷歌TPU等处理器,可以在基板上封装多片计算核心、HBM高速缓存。这项技术的好处除了可以提高芯片性能、缩短芯片间信号传输的距离,还可以支持5nm、3nm等不同制程的小芯片混搭在一起,不仅能够提高能效,还有助于降低成本。如今AP6封测厂的启用,代表了台积电在先进封装领域的里程碑进展。
台积电3D Fabric封装技术详解(幻灯片来自官方):
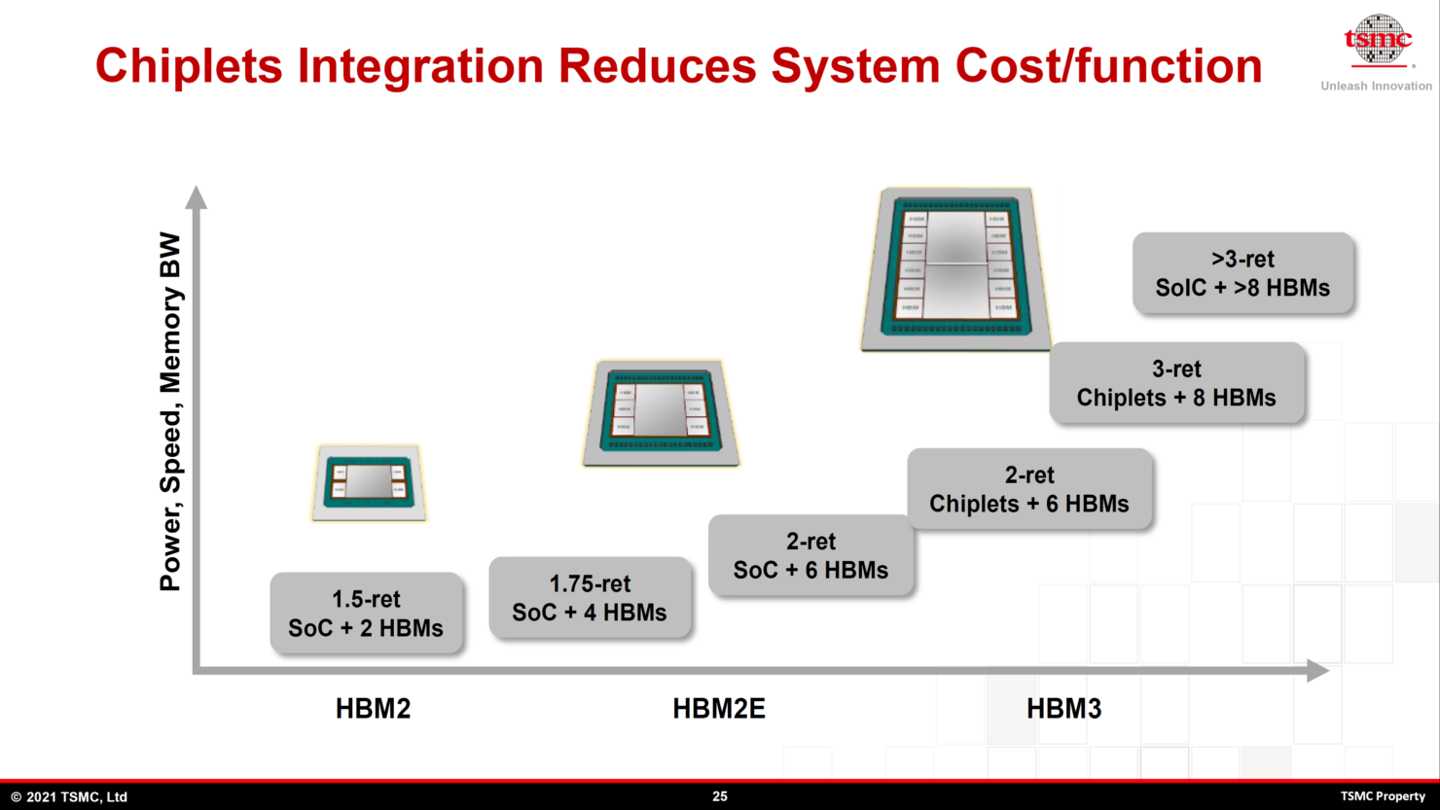


台积电表示,先进封测六厂建设工程于2020年7月启动,位于竹南科学园区,厂区面积14.3公顷,是台积电目前占地面积最大的封装测试厂。工厂投产后,预计每年可使用3D Fabric封装技术封装上百万片12英寸晶圆,此外每年可提供超过1000万小时的测试服务。
台积电总裁魏哲家表示,AP6工厂的及时建成,有助于缓解英伟达突然涌入的订单,也向各个客户传达了台积电先进封装产能无忧的重要信息。
台积电运营/先进封装技术暨服务、品质可靠性副总经理何军博士表示,“微芯片堆叠是提升芯片性能与成本效益的关键技术,为了响应强劲的3D IC三维立体电路市场需求,台积电已完成先进封装及硅晶堆叠技术产能的提前部署。”




全部评论